در حال حاضر، لیتوگرافی تجاری EUV از یک سیستم منبع نور ماوراء بنفش افراطی پلاسما (LPP-EUV) استفاده می کند که عمدتا از یک لیزر محرک، یک هدف قلع قطرات و یک آینه جمع کننده تشکیل شده است. پس از دو بمباران دقیق هدف قطرات قلع توسط لیزر محرک، قلع به طور کامل یونیزه می شود و تشعشع پرانرژی EUV تولید می کند که توسط آینه جمع کننده به نقطه کانونی (نقطه IF) منعکس و متمرکز می شود و سپس وارد می شود. انتقال بعدی مسیر نور.
فرآیند تحریک و تمرکز EUV اغلب با تولید و همگرایی باندهای نور دیگر (خارج از باند، OoB) همراه است. برخی از این چراغها را میتوان با استفاده از هیدروژن پسزمینه حذف کرد یا به نور مقاوم هستند، بنابراین تأثیر آنها حداقل است. با این حال، نوارهای نور دیگری نیز وجود دارند که می توانند آسیب جدی به کل سیستم لیتوگرافی وارد کنند و بر عملکرد تصویربرداری نهایی تأثیر بگذارند، مانند نور ماوراء بنفش عمیق (DUV) و نور مادون قرمز (IR) زیر 300 نانومتر. اولی از بمباران لیزری هدف قلع ناشی می شود که باعث کاهش کنتراست الگوی لیتوگرافی می شود زیرا مقاومت نوری به این نوار نور بسیار حساس است. در حالی که دومی از لیزر محرک ناشی می شود که انرژی بالای آن باعث درجات مختلف گرم شدن عناصر نوری، ماسک ها و ویفرها می شود که باعث کاهش دقت الگو و آسیب به عناصر نوری می شود. علاوه بر این، بازتاب سطح آینه جمع آوری روی اولی تقریباً مشابه سطح آینه EUV است، در حالی که بازتاب پذیری دومی نزدیک به 100٪ است همانطور که در شکل 1 نشان داده شده است. IR را به عنوان مثال به عنوان چراغ محرک در نظر بگیرید. منبع مورد نیاز قدرت لیزر برای 20 کیلو وات، پس از بازتاب آینه جمع آوری و همگرایی، قدرت آن برای رسیدن به نقطه IF هنوز نزدیک به 10٪ است، یعنی حدود 2 کیلو وات. با این حال، برای اینکه IR روی کل سیستم تقریباً هیچ تأثیری نداشته باشد، لازم است قدرت را در نقطه IF حداقل 1٪ کاهش دهید، یعنی فقط 20 وات زیر. با چنین تقاضای بالایی، لازم است تشعشعات OoB را فیلتر کرد، که اگر فیلتر نمی شد عملکرد سیستم منبع نور را به شدت کاهش می داد تا توسط آینه های کلکتور منعکس شود و وارد مسیر نور بعدی شود.
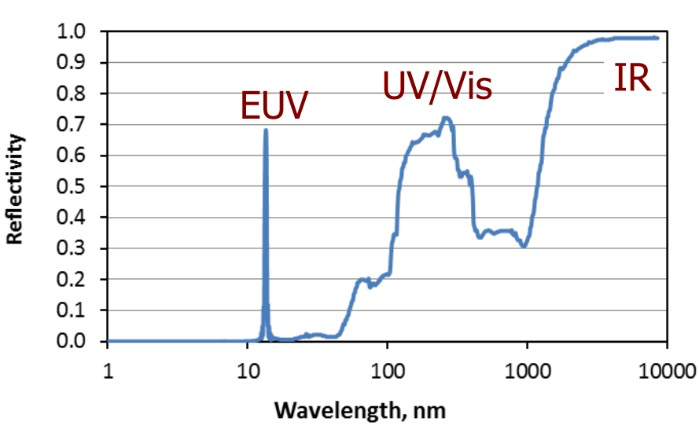
شکل 1 محاسبه انعکاس باندهای طول موج مختلف نور از یک 50-لایه مولیبدن/سیلیکون چندلایه با دوره 6.9 نانومتر و نسبت مولیبدن/سیلیکون 0.4 روی سطح آینه کلکتور .
ساختار فیلتر در سیستم منبع نور لیتوگرافی EUV
تیم نان لین و یوکسین لنگ از آزمایشگاه کلیدی دولتی فیزیک لیزر میدان شدید، موسسه ماشینهای نوری شانگهای، آکادمی علوم چین (SIOM)، به طور سیستماتیک فناوریهای کلیدی، چالشهای اصلی و روندهای آینده سیستمهای فیلتر EUVL را با با توجه به طول موج های خارج از باند در سیستم های منبع نور لیتوگرافی EUV.
نتایج در مقاله علوم و مهندسی لیزر با توان بالا 2023، شماره 5 (Nan Lin, Yunyi Chen, Xin Wei, Wenhe Yang, Yuxin Leng) منتشر شده است. بررسی [J]. علوم و مهندسی لیزر با توان بالا، 2023، 11 (5): 05000e64).
در سیستم های منبع نور EUVL، DUV تولید شده توسط پلاسما و IR که از منبع نور محرک منشا می گیرد معمولاً تأثیر زیادی بر عملکرد لیتوگرافی و طول عمر سیستم نوری و ساختار فیلم چند لایه مولیبدن/سیلیکون بر روی سطح دارند. آینه های کلکتور دارای بازتاب بالایی نسبت به آنها هستند، بنابراین سیستم فیلتر منبع نور EUVL عمدتا برای آنها طراحی شده است. DUV با شدت انرژی کم، استفاده از ساختار فیلم مستقل انتقال دهنده یا بازتابنده می تواند به اثر فیلتر خوب برسد، اما به دلیل استحکام مکانیکی کم ساختار فیلم آسان است که منجر به پارگی فیلم و سایر مشکلات شود، عمر مفید کوتاه تر است. در مقابل، IR با انرژی بالا را نمی توان به سادگی با استفاده از فیلترهای لایه نازک فیلتر کرد. درعوض، ساختارهای گریتینگ چندلایه باید روی زیرلایه آینه کلکتور (نشان داده شده در شکل 2) پردازش و پوشش داده شوند تا IR طول موج های خاص را با پراش فیلتر کنند و تا حد ممکن تابش EUV را حفظ کنند (نشان داده شده در شکل 3). ). این روش برای طراحی، پردازش و اندازهگیری ساختار گریتینگ، به ویژه در کنترل ناهمواری سطح گریت و یکنواختی لایههای چند لایه، و همچنین تأثیر پارامترهای ارتفاع سازه گریتینگ، تقاضاهای بسیار زیادی را ایجاد میکند. روی انعکاس، که باید آن را تنها به چند نانومتر یا حتی زیر نانومتر اندازه گیری کنیم. از نظر کل سیستم منبع نور EUVL، شی فیلتر تعیین می کند که وجود سیستم فیلتر نهایی در یک ساختار منفرد دشوار است، که باید هم ساختار لایه نازک مستقل و هم ساختار توری داخلی آینه جمع کننده را در نظر گرفت. به منظور درک تأثیر بر عملکرد لیتوگرافی OoB برای فیلتراسیون کلی، تا از خلوص منبع نور EUV اطمینان حاصل شود.

شکل 2 نمودار شماتیک ساختار توری تعبیه شده در آینه کلکتور.

شکل 3 نمودار شماتیک اصل فیلتر IR توسط ساختار توری داخلی آینه جمع آوری.
این مقاله راهحلهای فنی اصلی سیستم فیلتر منبع نور EUVL را خلاصه میکند، فناوری کلیدی فیلتر کردن تشعشعات OoB را تجزیه و تحلیل میکند، و چالشهای اصلی و روند توسعه آینده را در پرتو کاربردهای عملی مورد بحث قرار میدهد. عملکرد منبع نور EUV عملکرد لیتوگرافی را تعیین میکند. الگوها، و به منظور در نهایت به دست آوردن منبع نور EUV با خلوص بالا، لازم است طراحی سیستم فیلتر، فرآیند ساخت پیشرفته و روش اندازه گیری پیشرفته بهبود یابد. به منظور به دست آوردن منبع نور EUV با خلوص بالا، بهبود طراحی سیستم فیلتر، ساخت فرآیند و روش اندازه گیری ضروری است.





